X射线相干衍射成像( Ptychography / Coherent Diffraction Imaging):一种无透镜成像技术,可突破传统成像技术依赖高质量成像物镜的限制,实现衍射极限成像分辨率(<10nm),并可同时得到样品的吸收和相位图像(如下图所示):

● 对于弱吸收物质(例如生物样品),可得到高衬度相位图像(如下图所示):

● 可与层析成像(tomography)结合,无损地实现体块样品的三维高分辨率结构图像(如下图所示):
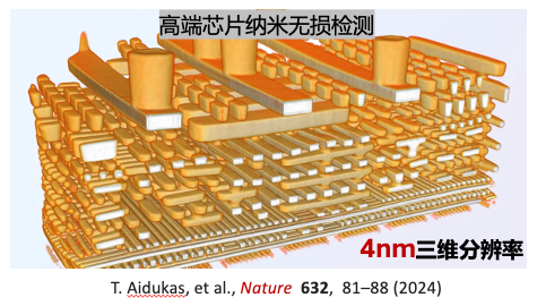
● 可结合X射线偏振(Circular/Linear Dichroism)结合,实现磁性样品的磁畴高分辨率成像(如下图所示):

● 可与谱学(spectroscopy)结合,实现样品化学价态的高分辨率成像(如下图所示):

● 可与荧光技术(Fluorescence)结合,实现样品元素的高分辨率成像(如下图所示):
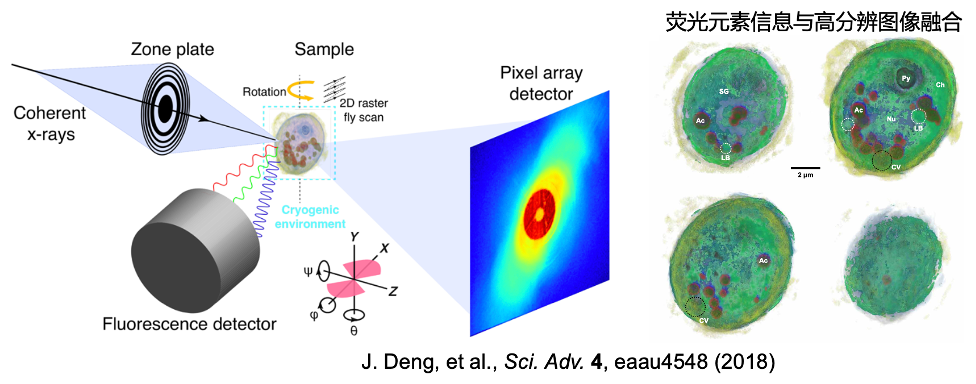
X射线布拉格晶体相干衍射成像(Bragg Ptychography / Coherent Diffraction Imaging):能实现对晶体内的晶格面偏移场进行高分辨率三维成像,从而能分析晶体内的各种缺陷及其产生的晶格应力(strain)进行表征(如下图所示)。对比于电镜技术(EBSD)可穿透更厚样品,实现体块样品的三维应力成像,而对比X射线衍射技术(micro-Laue Diffraction),有着更高的三维空间分辨率。

● 应用案例1: 通过原位三维布拉格相干X射线衍射成像技术,揭示了多相催化甲烷氧化过程中铂纳米晶体边缘的高晶格畸变现象。可直接观测到边缘区域因氧吸附引发的收缩应变,该应变在甲烷氧化过程中持续增强,并在反应完成后恢复初始状态。这种基于原位应变成像揭示的反应机制,不仅为催化剂性能优化提供了关键见解,也为未来纳米结构催化材料的设计指明了方向。

● 应用案例2:采用布拉格相干衍射成像技术,实现了工作状态下电池阴极纳米颗粒内位错动力学的三维动态观测。位错结构在室温条件下保持静态,但在电荷传输过程中呈现动态迁移;当发生结构相变时,富锂相优先在位错附近形核并呈现非均匀扩展。通过位错场分析材料弹性特性,发现材料在高电压状态下会出现负泊松比区域。这种工况条件下的位错动态成像技术,为纳米结构材料的性能优化和理性设计开辟了新途径。

● 应用案例3: 布拉格相干衍射成像技术,兼具高灵敏度、纳米级三维分辨率和大视场,可精准表征晶体材料中的晶格应变。通过布拉格扫描相干成像技术,测量了氦离子辐照在钨材料中产生的损伤,在三维尺度揭示了晶体结构细节和缺陷。结果表明:由数个原子构成的"不可见"缺陷可能呈各向同性分布,且在空间上均匀分散;但在晶界附近观察到了部分缺陷贫化区。

极紫外光刻技术应用与研究:
● 极紫外光刻掩模检测: 掩模是芯片的设计版图,是芯片制备全流程中的核心环节之一。EUV(极紫外)光刻是7nm以下工艺节点高端芯片关键层制备的主流技术,是集成电路战略的制高点。EUV光刻掩模通过在基底上镀Mo/Si多层膜实现较高的反射效率,由于多层膜镀膜技术壁垒高,制备流程繁琐,导致掩模价格高昂,一套7nm节点掩模成本约 1000‐1500万美元,由于现有工艺水平无法实现无缺陷掩模制造,因此必须通过高灵敏度缺陷检测和修复技术以避免因掩模缺陷导致器件失效。多层膜掩模缺陷主要分为两种:振幅缺陷和相位缺陷,振幅缺陷主要分布在多层膜表面附近,可被传统的手段(如扫描电镜)检测,而相位缺陷分布在多层膜底部和中间位置,传统的电镜和光学手段很难探测,只有采用与光刻工艺相同波长的光(13.5nm)才能进行可靠的探测(如图6所示)。国际上成熟的商业化EUV掩模成像检测设备通常采用施瓦兹镜系统,但是国内高精度高质量的施瓦兹镜的自主研制还尚需一定的时间。相干衍射成像技术不需要任何成像物镜,很好地规避了对高质量物镜的要求,而且还拥有极高的衍射极限分辨率的优点,成像结果无像差,并能同时提供掩模的振幅和相位图像,在检测多层膜掩模相位缺陷方面表现出巨大潜力。
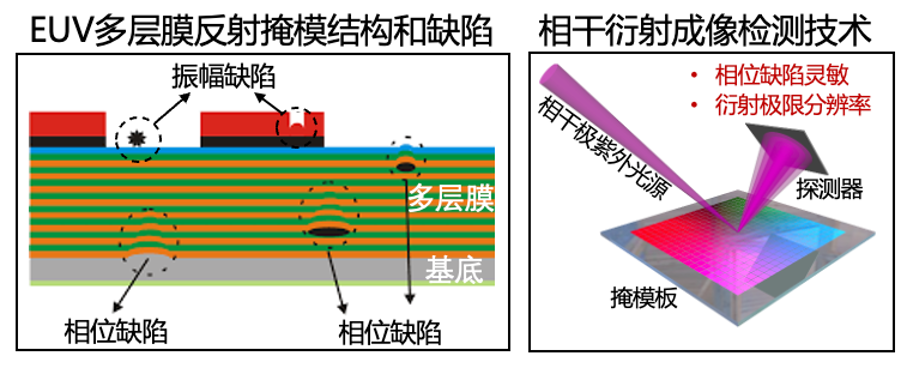
● 极紫外全息光刻(Holographic Lithography,HL): 是基于全息衍射成像发展而来的一种无透镜投影系统的光刻技术,它利用光的衍射及干涉效应构建空间像来制作集成电路板图。不同于传统投影光刻技术,全息光刻技术的曝光工艺无需依赖投影物镜系统,投影型掩模被替换成全息型掩模,光波透过掩模在介质自由传播到达晶圆产生目标图像,这很好地规避了投影物镜系统造价昂贵,成本较高的问题,且与现有的投影式光刻工艺兼容,能够直接应用于当前的EUV系统中。采用EUV-HL技术路线,可利用我国在投影式光刻机领域已经形成的技术积累和供应链体系,在此基础上探索一条可替代的、具有自主知识产权体系的新型光刻机路线,不仅为我国在半导体领域的自主创新提供了新途径,也有望打破国外在高端光刻设备上的技术垄断,推动未来半导体制造技术的发展。